背景概念?
光刻的概念:光刻是當前半導體、平板顯示、MEMS、光電子等行業的關鍵工藝環節。光刻技術是指在短波長光照作用下,以光刻膠(光致抗蝕劑、photoresist)為介質,將微納圖形制備到基片上的技術。以半導體工藝為例,半導體器件由多種專用材料經過光刻、離子刻蝕、拋光等復雜微納加工流程而完成。光刻設備是半導體工藝中最核心的裝備, 在掩模版制備、芯片制造和封裝環節都使用了光刻技術。
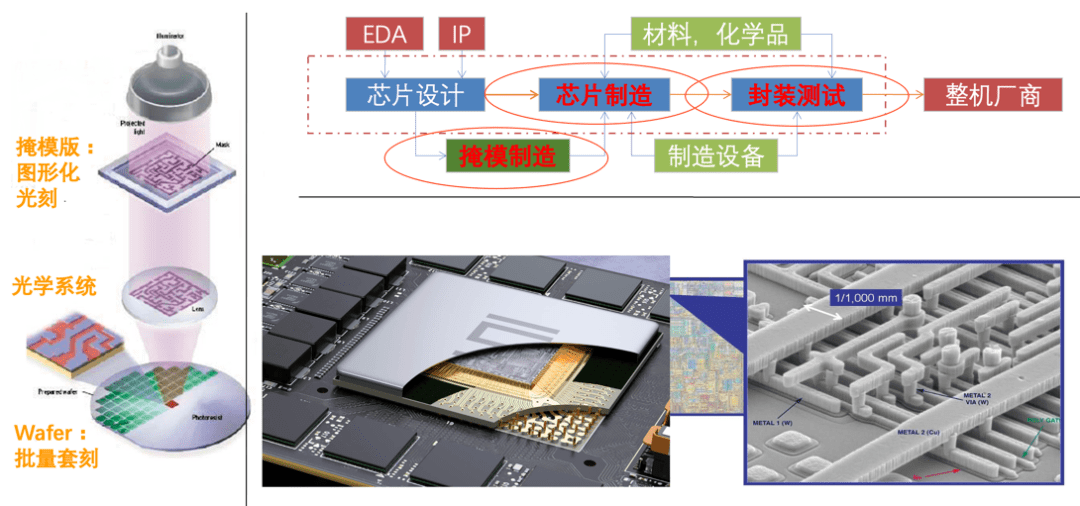
光刻在半導體制程中的作用示意圖
光刻技術類型分為直寫光刻和投影光刻兩個大類。其中直寫光刻是器件中微納結構源頭制備的關鍵環節,實現將計算機設計數據制備到特定基板上,形成高精度微納結構的圖形布局。
直寫光刻的概念:直寫光刻系統在英文中被稱為Pattern Generator,是微納圖形生成的手段,將計算機設計的GDSII、DXF等圖形文件制作成實物版圖。
用傳統打印與復印的區別來打個比方:
·直寫光刻是打印,將計算機中的文件打印出來。
· 投影光刻是復印,實現器件制造的批量化。 不過這個“復印”過程需要多套圖形的對準復印,要求極高的對準精度、分辨率和一致性。
光刻技術分類及作用
激光直寫和電子束直寫是產業中兩項主要的直寫技術。激光直寫可以滿足半導體0.25微米及以上節點掩模版制備,以及0.25微米以下部分掩模版制備。當前半導體掩模版總量的約75%由激光直寫設備制備,其余掩模版由電子束直寫設備完成。平板顯示領域的大幅面掩模版,100%由激光直寫設備制備。
在投影光刻領域,半導體采用微縮投影光刻技術,代表性供應商是荷蘭ASML;平板顯示采用大幅面投影光刻,代表性廠商是日本尼康。在諸多研發、MEMS、LED等領域,掩模版接觸/接近式光刻依然廣泛使用。

光刻技術類型示意圖
先進激光直寫光刻技術
直寫光刻與投影光刻技術是當前產業中分工明確的兩類光刻技術,投影光刻具有更高的線寬分辨率、精度和生產效率的特點。雖然直寫光刻還不能滿足器件大規模制造的需求,但在電路板行業,激光直寫替代傳統曝光機是明確的趨勢,實現無掩模光刻一直是產業追求的理想目標,可減少昂貴掩模版的支出,提升新品開發效率,滿足小批量多樣化生產需求。此外,直寫光刻由于其數字化的屬性,具有更高的靈活性和廣泛適應性。可開發創新的曝光方式,作為數字化微納加工的基礎性技術,從而有望成為半導體、光電子相關產業中工藝迭代升級、新產品創新的關鍵性技術。
在具有襯底翹曲、基片變形的光刻應用領域,直寫光刻的自適應調整能力,使之具有成品率高、一致性好的優點。如FanOut、COF等先進封裝模式的發展,封裝光刻技術需要具有更小的線寬、更大的幅面、更好的圖形對準套刻適應能力。
在微納光電子新興領域,ALoT的發展需要大量光電傳感器件的創新研發。3D光刻與微納制造是光電子產品創新的基石性技術,具有眾多的產業應用價值,如3D感知、增強現實顯示、光傳感器件(如TOF)、超薄成像、立體顯示、新型光學膜等。微納光子器件逐步在智能手機、增強現實AR、車載領域應用。與集成電路圖形不同,微納光子傳感器件要求更高的位置排列精度及縱向面型精度、結構形貌具有密集連續曲面形貌的特點。因此,新型3D直寫光刻技術,實現曝光寫入劑量與位置形貌精確匹配,是制備新型光電子傳感器件級微納結構形貌的創新技術路徑。
3D直寫光刻技術進展
蘇大維格通過產學研合作,一直致力于推進3D直寫光刻技術開發與應用,解決了多項行業挑戰:
1
大面積微納結構形貌的數字設計,海量數據處理與先進算法,可達百Tb量級數據量
2
海量數據數據壓縮傳輸、高速率光電轉換技術
3
數字光場形成三維形貌的曝光模式與機理,3D臨近效應校正技術
4
微納結構形貌精確光刻工藝和運行模式
5
大型運動平臺與光機系統的制造工藝、納米精度控制技術
當前已經取得了3D光刻工藝突破,實現了光刻膠3D形貌可控制備。SEM結果舉例如下:

芯片光掩模
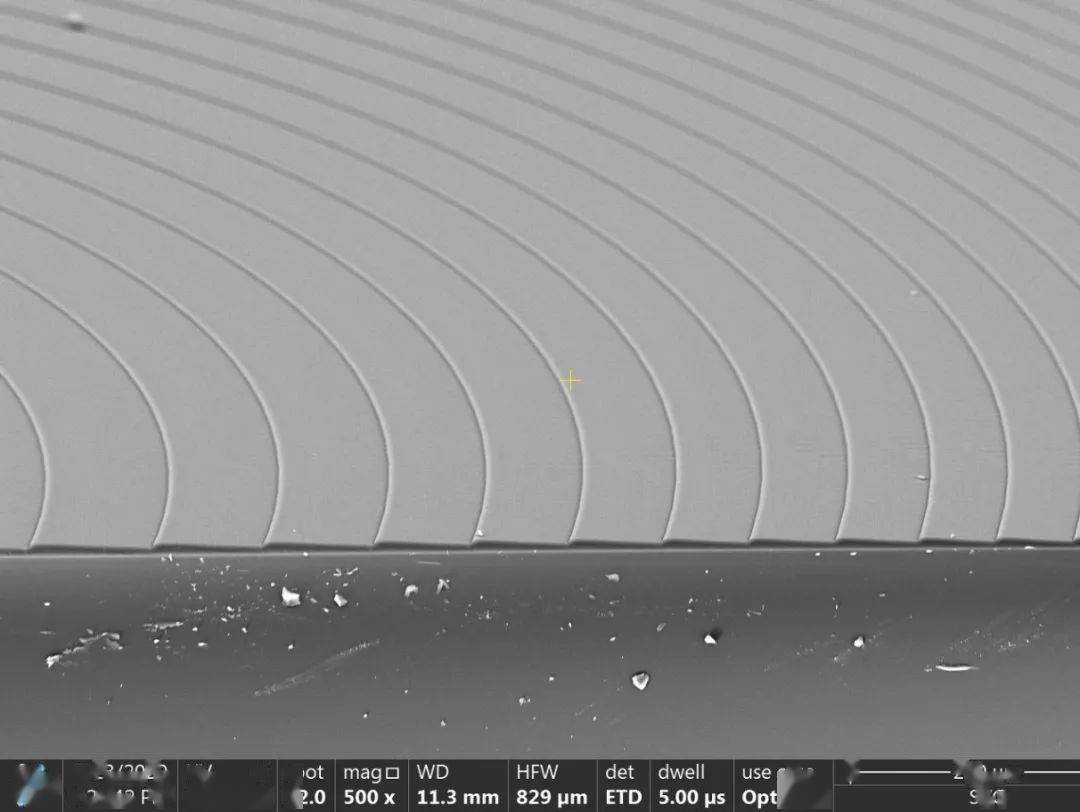
超薄菲涅爾成像透鏡
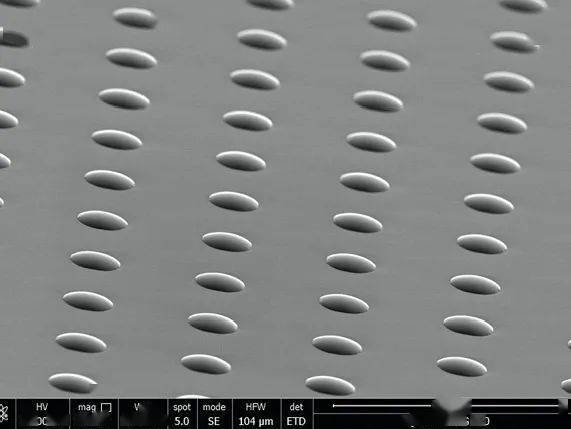
微透鏡陣列
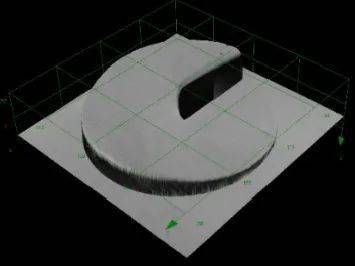
渦旋結構
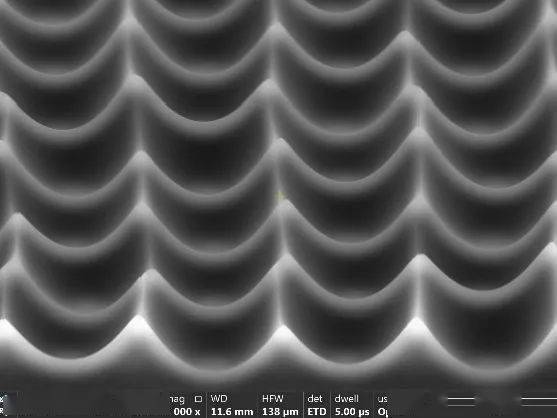
ToF勻光器件

結構光DOE

電子紙微杯
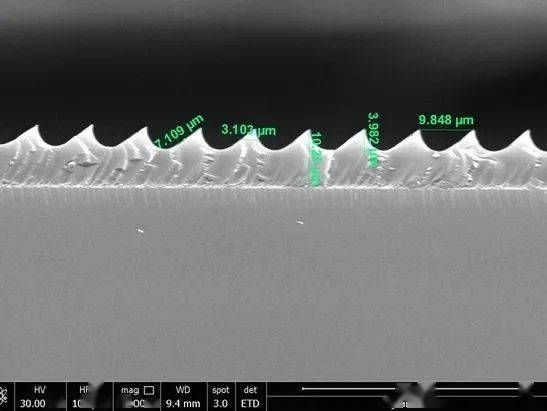
減阻結構
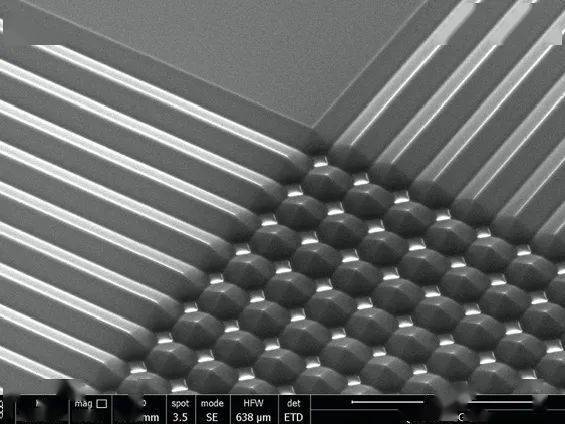
微流控
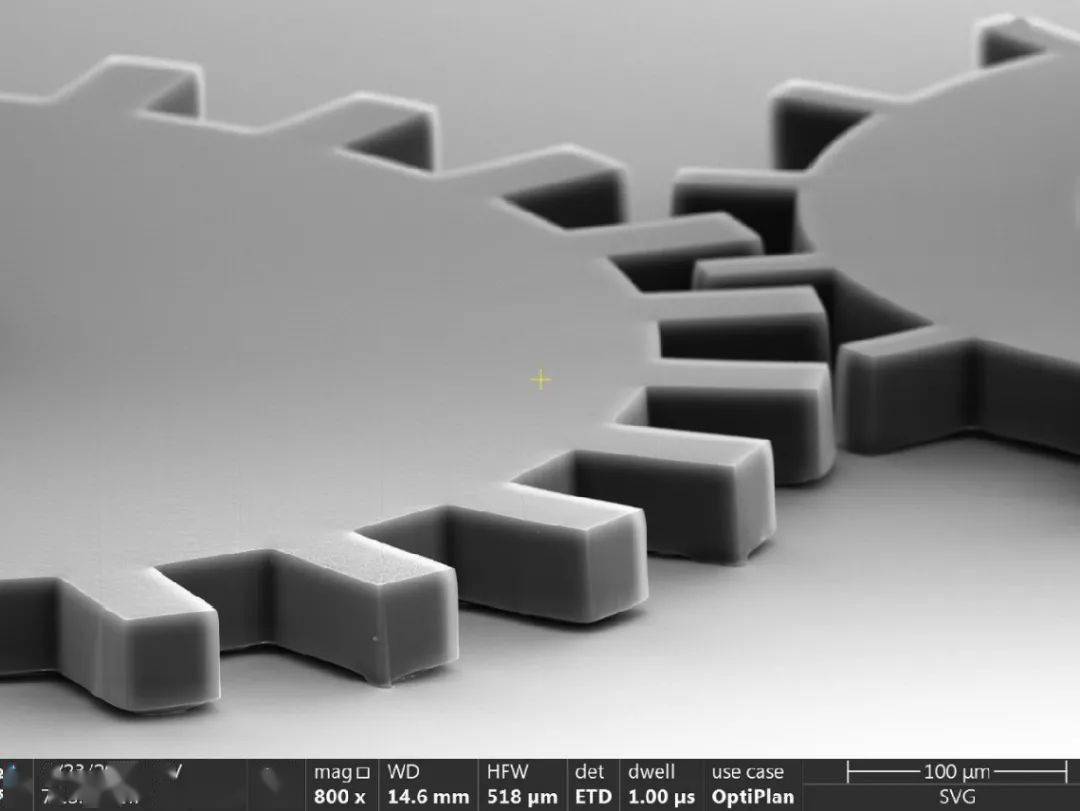
MEMS
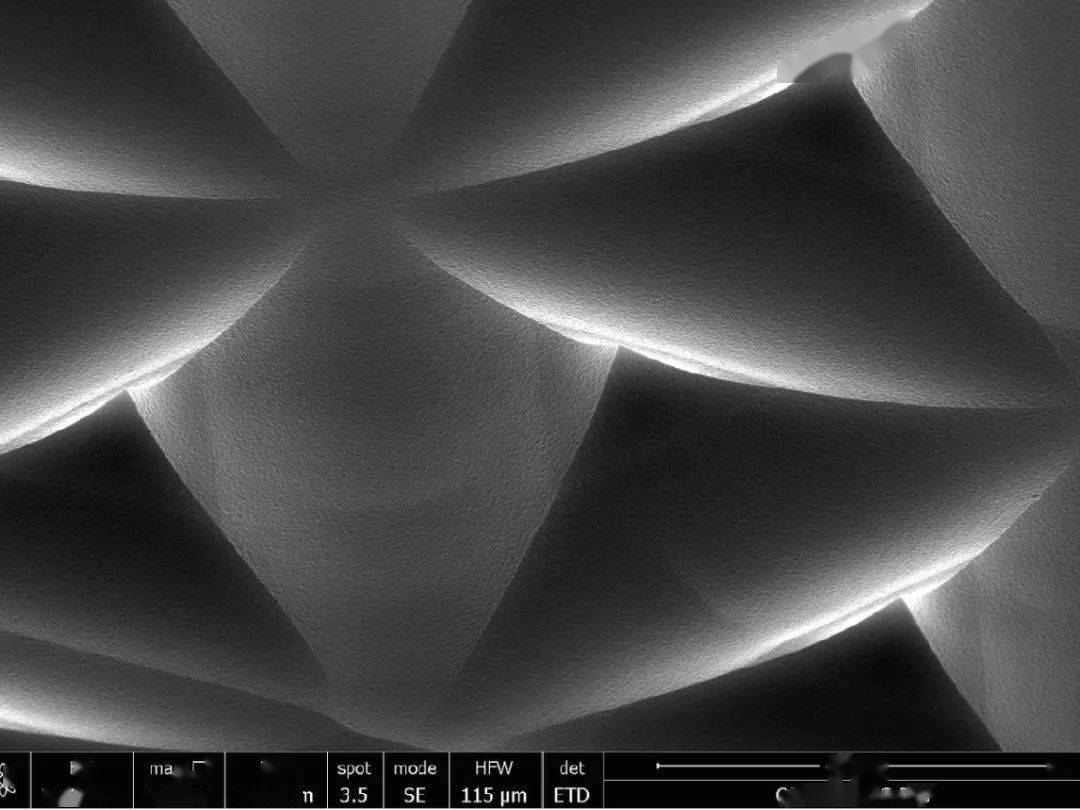
微棱錐

立體成像結構
來源:蘇大維格返回搜狐,查看更多